 |
Приборы для исследования полупроводников |
 |
IMS Wf-SC UltraАвтоматизированный SIMS с магнитным сектором, оптимизированный для профильного анализа следов элементов в сверхтонких структурах, с высокой чувствительностью (до атомной концентрации в ppb) и высоким разрешением по глубине (лучше одного nanometer). IMS Wf позволяет работать с подложками до 300mm и совместим с FAB. Применяется главным образом для определения примесей при имплантировании , измерения глубины перехода, исследования процессов (получение характеристик имплантанта, осаждения, отжига…). Прибор применяется в кремниевой технологии, технологиях SiGe, и групп II-VII, III-V. |
 |
IMS 7fУниверсальный SIMS с магнитным сектором для глубинного профилирования с высокой чувствительностью (до атомной концентрации в ppb) и 2D или 3D изображения следов элементов. Широко применяется для определения примесей при имплантировании , измерения глубины перехода, исследования процессов (получение характеристик имплантанта, осаждения, отжига…). Прибор применяется в кремниевой технологии, технологиях SiGe, и групп II-VII, III-V. |
 |
Shallow ProbeМетрологический прибор с высокой производительностью для линии FAB для измерений состава и толщины имплантантов ULE и сверхтонких пленок. Основан на недеструктивном методе
LEXES и совместим с анализом промышленных подложек. Обработке подвергаются кассеты с 200- и 300-мм подложками, что полностью соответствует стандартам SEMI и SECS/GEM. Применение: количественная оценка B, Ge и C в SiGe, измерение примесей при сверхнизкой энергии и количественная оценка азота-кислорода в сверхтонких оксинитридах. |
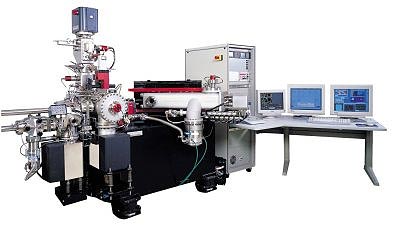 |
NanoSIMS 50Микроанализатор
SIMS с мультиколлекторным детектором для анализа с получением сверхточных характеристик. Делает возможным высокое разрешение при 2D картировании следов элементов и примесей. Дает пределы обнаружения элементов в ppm при разрешении 50nm. |
|
|

